
FSM 薄膜应力量测设备 FSM 多层晶圆厚度量测设备
各层Layer与薄膜厚度量测
使用Echoprobe™技术,藉由IR光可穿透物质的特性(金属层除外),穿透多层材料结构,并于各层材料界面接收反射光谱,同时搭配折射率(Reflective index)计算待测层厚度(Thickness)。此技术广泛适用于所有IR可穿透材料之厚度量测。
FSM 晶圆厚度量测设备特点
- 量测范围广,可量测30nm~780um的厚度范围,总厚可达3mm(支持薄膜量测Thin-film measurement)
- 支持12”wafer、Panel样品量测;提供各式产品厚度、翘曲度(Warp)量测方案
- 提供真空载台,提供Nano-topography测量时的稳定性
- 同一传感器(IR sensor)可进行多种功能量测,并同时完成多层晶圆厚度量测任务
- 可编程软件,搭配全自动量测,可同步量测产品之正反面信息
- 快速且准确的量测,具奈米级的重复性与再现性
- 可自动生成量测报告,节省工作时间
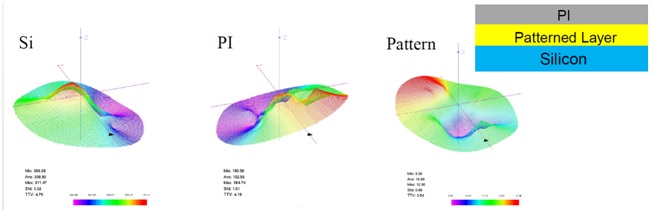
FSM 晶圆厚度量测设备应用
广泛适用于半导体、电子、LED、太阳能、FPD平板显示器、MEMS等产业。以电子及半导体产业为例,FSM可应用于:
- 多层晶圆厚度量测(含薄膜):Silicon、AlN、Tape、PR、PI、Glass…等可穿透材料厚度
- Wafer形貌分析:Bow/ Warpage(翘曲)、总厚度变异(TTV)、Thickness
- 表面形貌、尺寸量测:锡球高度Bump Height, 切割道、段差、表面粗糙度Roughness
- 先进制程量测:3DIC量测、TSV量测、Panel量测
近年来,半导体除了持续在前段将制程尺寸微缩外,也同步在后段封装进行异质整合,以获取更高的连接密度、并大幅改善芯片能效。随着封装维度的提升,由现行晶圆级封装(WLP, Wafer Level Package)逐步向面板级封装拓展(PLP, Panel Level Package),在过程中可能面临的阻碍,包括:各层厚度的均匀性、由内部应力所引发的Warp翘曲…等问题。
对于制程而言,当产品本身平整度不足时,将导致后续工序出现一系列问题,因此Wafer / Panel的厚度(Thickness)&翘曲量测(Warpage),成为了现今导入Wafer / Panel Level Package相当重要的课题。
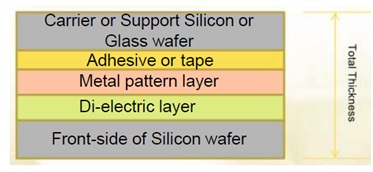
若您对我司所代理之FSM多层晶圆厚度量测设备有兴趣,欢迎来电或来信询问。


