
FSM 薄膜應力量測設備 FSM 多層晶圓厚度量測設備
各層Layer與薄膜厚度量測
使用Echoprobe™技術,藉由IR光可穿透物質的特性(金屬層除外),穿透多層材料結構,並於各層材料界面接收反射光譜,同時搭配折射率(Reflective index)計算待測層厚度(Thickness)。此技術廣泛適用於所有IR可穿透材料之厚度量測。
FSM 晶圓厚度量測設備特點
- 量測範圍廣,可量測30nm~780um的厚度範圍,總厚可達3mm(支援薄膜量測Thin-film measurement)
- 支援12”wafer、Panel樣品量測;提供各式產品厚度、翹曲度(Warp)量測方案
- 提供真空載台,提供Nano-topography測量時的穩定性
- 同一感測器(IR sensor)可進行多種功能量測,並同時完成多層晶圓厚度量測任務
- 可編程軟體,搭配全自動量測,可同步量測產品之正反面資訊
- 快速且準確的量測,具奈米級的重複性與再現性
- 可自動生成量測報告,節省工作時間
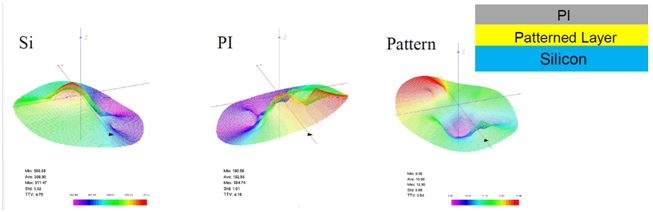
FSM 晶圓厚度量測設備應用
廣泛適用於半導體、電子、LED、太陽能、FPD平板顯示器、MEMS等產業。以電子及半導體產業為例,FSM可應用於:
- 多層晶圓厚度量測(含薄膜):Silicon、AlN、Tape、PR、PI、Glass…等可穿透材料厚度
- Wafer形貌分析:Bow/ Warpage(翹曲)、總厚度變異(TTV)、Thickness
- 表面形貌、尺寸量測:錫球高度Bump Height, 切割道、段差、表面粗糙度Roughness
- 先進製程量測:3DIC量測、TSV量測、Panel量測
近年來,半導體除了持續在前段將製程尺寸微縮外,也同步在後段封裝進行異質整合,以獲取更高的連接密度、並大幅改善晶片能效。隨著封裝維度的提升,由現行晶圓級封裝(WLP, Wafer Level Package)逐步向面板級封裝拓展(PLP, Panel Level Package),在過程中可能面臨的阻礙,包括:各層厚度的均勻性、由內部應力所引發的Warp翹曲…等問題。
對於製程而言,當產品本身平整度不足時,將導致後續工序出現一系列問題,因此Wafer / Panel的厚度(Thickness)&翹曲量測(Warpage),成為了現今導入Wafer / Panel Level Package相當重要的課題。
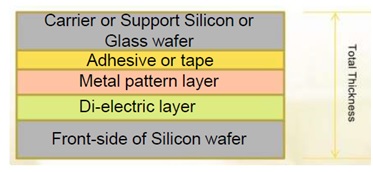
若您對我司所代理之FSM多層晶圓厚度量測設備有興趣,歡迎來電或來信詢問。


