
Micro LED檢查系統 拉曼顯微鏡
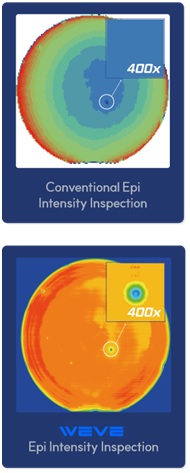
傳統Epi檢測工具已經無法跟上Micro LED的結構,WEVE新一代Epi系統已經突破這些限制。
1.解析度比傳統工具高出40倍。傳統PL無法捕捉最細小的缺陷和不均勻。
2.從發射強度和物理缺陷到波長和顏色分析,除了高解析的影像之外,同時提供每個微觀結構的完整資訊如顏色座標資訊及Wd(主發光波長)。
3.下一代的解決方案,專為Micro LED打造的解決方案。
4.非接觸式、非破壞性掃描高速檢查,可以快速檢查6吋晶圓,不造成損壞,同時保留每個細節。
WEVE獨家技術
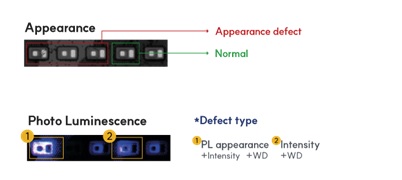
一次掃描就能將micro LED的外觀檢查、PL(PL強度、PL顯示)和色差分析、WD(Domain Wavelength)、xyY完成。
1.12分鐘完成6吋CoW晶圓檢測,WEVE的Bandi利用高速平台及獨家計算軟體,12分鐘內檢查完整的6吋CoW,超過1000萬個micro LED的所有資訊,與傳統的單獨特性檢查不同,大幅減少掃描時間,提高生產力。
2.非接觸、非破壞、超高解析解查,系統採用雷射的PL、和光學檢查,其非接觸、非破壞的方式確保檢測過程不會對Micro LED晶圓造成應力破壞。解析度小於1um。
3.同時量測形狀、發射特性、顏色座標,Bandi透過簡單的流程,同時測量外觀、PL、WD、xyY顏色座標,在一次的掃描流程就能完成,降低跨裝置、步驟的低效作業模式,有效進行缺陷分析及原因識別。

Bendi透過EL(電致發光)檢查,提升的既有的PL檢查準確性,其中EL影像的亮度變化是由於微型探針的接觸力道不同所導致,接觸力道影響電流注入的差異,產生亮度變化。

